CMOS 逻辑和存储器共同构成了半导体器件生产的绝大部分。本文考虑的内存类型是 DRAM 和非易失性内存 (NVM)。重点是商品、独立芯片,因为这些芯片往往会推动内存技术。然而,嵌入式存储芯片预计将遵循与商品存储芯片相同的趋势,通常会有一些时间滞后。对于 DRAM 和 NVM,都考虑了详细的技术要求和潜在的解决方案。
DRAM的发展方向
对于 DRAM,主要目标是继续将 1T-1C 单元的封装尺寸扩大到 4F2 的实际极限。挑战在于垂直晶体管结构、高 κ 电介质以提高电容密度,同时保持低泄漏。一般来说,DRAM 的技术要求随着缩放而变得更加困难。在过去的几年中,DRAM 引入了许多新技术(例如,193 nm 氟化氩 (ArF) 浸没式High NA 光刻技术和双图形技术、改进的单元 FET 技术,包括鳍型晶体管、掩埋字线/单元 FET 技术等等)。
由于 DRAM 存储电容器在物理上随着尺寸缩小而变小,因此等效氧化物厚度 (EOT) 必须急剧缩小以保持足够的存储电容。为了扩展 EOT,需要具有高相对介电常数 (κ) 的介电材料。因此,采用高κ(ZrO2/Al2O/ZrO2)的金属-绝缘体-金属(MIM)电容器作为接地规则在48nm和30nm半间距之间的DRAM的电容器。和这个材料进化和改进一直持续到 20 nm HP 和超高 κ(钙钛矿 κ > 50~100)材料被释放。此外,高 κ 绝缘体的物理厚度应按比例缩小以适应最小特征尺寸。因此,电容器的 3-D 结构将从圆柱形变为柱形。
另一方面,随着外围CMOS器件的微缩,这些器件形成后的工艺步骤需要低温工艺流程。这对于通常在 CMOS 器件形成后构建的 DRAM 单元工艺来说是一个挑战,因此仅限于低温处理。DRAM 外围设备要求可以放宽 Ioff 但需要更多 Ion 的低待机功耗 (LSTP) 设备。但是,在未来,将需要高 κ 金属栅极来维持性能。
另一个重要主题是从 6F2 到 4F2 cell的迁移。由于半间距缩放变得非常困难,因此不可能维持成本趋势。保持成本趋势并逐代增加总比特输出的最有希望的方法是改变单元尺寸因子 (a) 缩放比例(其中 a = [DRAM 单元尺寸]/[DRAM 半间距])。目前 6F2(a = 6)是最常见的。例如,垂直单元晶体管是必需的,但仍然存在一些挑战。另一种选择是使用 3D DRAM。
总之,需要保持足够的存储电容和足够的单元晶体管性能以在未来保持保留时间特性。他们的困难要求正在增加,以继续扩展 DRAM 设备并获得更大的产品尺寸(即 >16 Gb)。除此之外,如果与引入新技术相比,成本微缩的效率变差,那么DRAM微缩将会停止,而采用3D单元堆叠结构,或者采用新的DRAM概念。
Flash的演进方式
有几种交叉的存储器技术具有一个共同的特征——非易失性。要求和挑战因应用而异,范围从仅需要 Kb 存储的 RFID 到芯片中数百 Gb 的高密度存储。非易失性存储器可分为两大类——闪存(NAND Flash 和 NOR Flash)和非基于电荷的存储存储器。非易失性存储器基本上无处不在,许多应用程序使用通常不需要前沿技术节点的嵌入式存储器。More Moore 非易失性存储器表仅跟踪前沿独立部件的存储器挑战和潜在解决方案。
闪存基于简单的单晶体管 (1T) 单元,其中晶体管既用作访问(或单元选择)设备又用作存储节点。目前闪存服务于99%以上的应用。
当存储电子的数量达到统计极限时,即使可以进一步缩小器件尺寸,实现更小的单元,存储器阵列中所有器件的阈值电压分布也变得不可控,逻辑状态不可预测。因此,存储密度不能通过持续缩放基于电荷的设备来无限增加。然而,通过垂直堆叠存储层可能会继续有效提高密度。
通过完成一个设备层然后完成另一层等等来堆叠的经济性值得怀疑。如图 MM-9 所示,在堆叠几层设备后,每位成本开始上升。此外,由于复杂处理增加的互连和良率损失导致阵列效率下降,可能会进一步降低此类 3D 堆叠的每比特成本优势。
在2007 年,业内提出了一种“punch and plug”方法来垂直制造位线串,以大大简化加工步骤。这种方法使 3D 堆叠设备只需几个步骤,而不是通过重复处理,从而为 NAND 闪存提供了一条新的低成本扩展路径。图 MM-9 说明了一种这样的方法。最初创造的bit-cost-scalable(或 BiCS)架构将 NAND 串从水平位置转为垂直位置 90 度。字线(WL)保持在水平面上。如图 MM-9 所示,这种类型的 3D 方法比完整设备的堆叠要经济得多,并且成本效益不会达到相当高的层数。
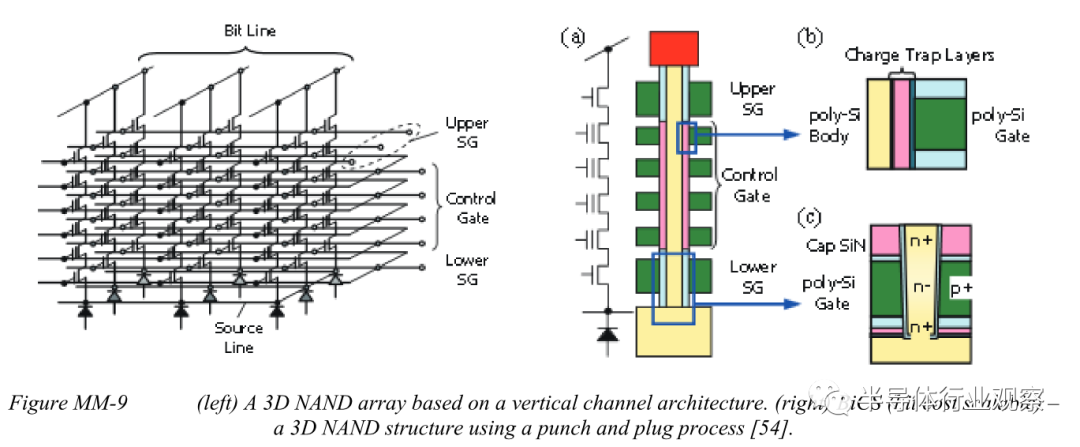
自 2007 年以来,已经提出了许多基于 BiCS 概念的架构,当中包括一些使用浮栅而不是电荷捕获层进行存储的架构,这些技术在过去 2-3 年中已经投入量产。一般来说,所有 3D NAND 方法都采用了一种策略,即使用比传统 2D NAND 大得多的面积占用空间。3D NAND 的 x 和 y 尺寸(相当于 2D 中的单元尺寸)在 100nm 范围内甚至更高,而最小的 2D NAND 约为 15nm。更大的“单元尺寸”是通过堆叠大量存储层来实现具有竞争力的封装密度的。
3D NAND 的经济性因其复杂而独特的制造需求而变得更加混乱。尽管较大的单元尺寸似乎放宽了对细线光刻的要求,但要实现高数据速率,*使用large page size尺寸,而这又会转化为细间距位线和金属线。因此,即使单元尺寸很大,金属线仍然需要约 20nm 的半间距,这只能通过具有双图案的 193i 光刻来实现。深孔刻蚀难度大、速度慢,刻蚀产量一般很低。沉积多层电介质和/或多晶硅,以及多层膜和深孔的计量都是对陌生领域的挑战。这些都转化为对新设备和占地面积的大量投资,以及对晶圆流和良率的新挑战。
最终的未知数是可以堆叠多少层。
层的堆叠似乎没有硬性物理限制。超过一定的纵横比(也许是 100:1?)时,当反应离子蚀刻过程中的离子被侧壁上的静电荷弯曲并且不能进一步向下移动时,蚀刻停止(etch-stop)现象可能会限制一次操作中可以蚀刻的层数 . 然而,这可以通过堆叠更少的层、蚀刻和堆叠更多的层(以更高的成本)来绕过。
堆叠许多层可能会产生使晶圆弯曲的高应力,尽管这需要仔细设计,但它似乎并不是无法解决的物理极限。即使在 200 层(每层约 50nm)时,总堆叠高度约为 10µm,仍然与逻辑 IC 的 10-15 层金属层处于同一范围内。这种层厚度不会显着影响裸芯片厚度(目前最薄约为 40µm)。
然而,在 1000 层时,总层厚度可能会导致厚die不符合在薄封装中堆叠多个die(例如,16 或 32)的形状因数。目前量产176层,300+层有望实现,甚至500、800层也有可能。除了处理挑战之外,堆叠更多层还增加了接触更多字线所需的面积开销。该区域开销,加上增加的处理复杂性,最终将通过添加更多层来降低成本效益。
当堆叠更多层被证明太困难时,面积 x-y 足迹的重新缩小可能最终会开始。然而,这种趋势并不能保证。如果孔纵横比是限制因素,那么缩小占位面积不会降低该比率,因此也无济于事。此外,与紧密间距的 2D NAND 相比,更大的单元尺寸似乎至少部分有助于 3D NAND 的更好性能(速度和循环可靠性)。x-y 缩放是否仍能提供这样的性能尚不清楚。
因此,未来几代的路线图预测在 2022 年与当前节点保持一致。另一方面,增加每个存储单元的存储位数虽然在技术上具有挑战性,但似乎取得了进展。这在一定程度上是为了利用 3D NAND 器件本质上更大,因此存储的电子更多,更容易制成更多的逻辑电平。
目前 4 位/单元器件 (QLC) 正在量产,并且乐观地认为 5 位/单元甚至更多可能在不久的将来变得可行。一个单元中更多的存储位需要在性能上做出一些折衷,因为它需要更长的时间来编程和读取,并且在将逻辑电平压缩在一起时可靠性会受到影响。然而对于许多读取密集型应用程序来说,为了降低成本,这种权衡是可以接受的。
新兴存储的不确定性
由于存储电荷太少,2D NAND Flash 缩放受到统计波动的限制,一些不基于电荷存储的非常规非易失性存储器(铁电或 FeRAM、磁性或 MRAM、相变或 PCRAM,以及电阻或 ReRAM)正在开发中,形成通常称为“新兴”存储器的类别。
尽管 2D NAND 正在被 3D NAND 取代(不再受制于电子太少的缺点),但基于非电荷的新兴存储器的一些特性(例如低电压操作或随机存取)正在被各种各样的应用关注从而获得继续发展的机会。这些新兴的存储器通常具有两端结构(例如,电阻器或电容器),因此很难同时用作单元格选择设备。存储单元一般以1T-1C、1T-1R或1D-1R的形式结合单独的存取器件。
FeRAM:铁随机存储器
FeRAM 器件通过切换和感测铁电电容器的极化状态来实现非易失性。要读取内存状态,必须跟踪铁电电容器的磁滞回线( hysteresis loop),并且存储的数据被破坏并且必须在读取后写回(破坏性读取,如 DRAM)。由于这种“破坏性读取”,找到既能提供足够的极化变化又能在延长的工作周期内保持必要稳定性的铁电材料和电极材料是一项挑战。
许多铁电材料对于 CMOS 制造材料的正常补充来说是陌生的,并且可以通过传统的 CMOS 处理条件退化。FeRAM 速度快、功耗低、电压低,因此适用于 RFID、智能卡、ID 卡和其他嵌入式应用。处理难度限制了它的广泛采用。最近,提出了基于 HfO2的铁电 FET,其铁电性用于改变 FET 的 Vt,从而可以形成类似于闪存的 1T 单元。如果开发成熟,这种新存储器可以用作低功耗且速度非常快的类似闪存的存储器。
MRAM:磁性内存
MRAM (Magnetic RAM) 设备采用磁性隧道结 (MTJ:magnetic tunnel junction) 作为存储元件。MTJ 单元由两种铁磁材料组成,由用作隧道势垒的薄绝缘层隔开。当一层的磁矩切换为与另一层对齐(或与另一层的方向相反)时,电流流过 MTJ 的有效电阻会发生变化。可以读取隧道电流的大小以指示存储的是“一”还是“零”。场切换 MRAM 可能是最接近理想的“通用存储器”的,因为它是非易失性的、快速的并且可以无限循环。因此,它可以用作 NVM 以及 SRAM 和 DRAM。
然而,在 IC 电路中产生磁场既困难又低效。尽管如此,Field Switching MTJ MRAM已经成功制成产品。然而,当存储元件缩放时,切换所需的磁场会增加,而电迁移会限制可用于产生更高 H 场的电流密度。因此,预计现场开关 MTJ MRAM 不太可能扩展到 65nm 节点以上。
“STT(spin-transfer torque )”方法的最新进展提供了一种新的潜在解决方案,其中自旋极化电流将其角动量转移到自由磁性层,从而在不借助外部磁场的情况下反转其极性。在自旋转移过程中,大量电流通过 MTJ 隧道层,这种应力可能会降低写入耐久性。在进一步缩放时,存储元件的稳定性会受到热噪声的影响,因此预计在 32nm 及以下需要垂直磁化材料。最近已经证明了垂直磁化。
随着NAND Flash的快速发展,以及最近推出的有望继续等效缩放的3D NAND,STT-MRAM取代NAND的希望似乎渺茫。然而,其类似 SRAM 的性能和比传统 6T-SRAM 小得多的占用空间在该应用中引起了极大的兴趣,特别是在不需要高循环耐久性的移动设备中,例如在计算中。因此,STT-MRAM 现在大多不被视为独立内存,而是嵌入式内存 ,并且不在独立 NVM 表中进行跟踪。
STT-MRAM 不仅是嵌入式 SRAM 替代品的潜在解决方案,也是嵌入式闪存 (NOR) 替代品的潜在解决方案。这对于物联网应用来说可能特别有趣,因为低功耗是最重要的。另一方面,对于使用更高存储密度的其他嵌入式系统应用,预计 NOR 闪存将继续占据主导地位,因为它仍然更具成本效益。此外,闪存能够承受 PCB 板焊接过程(约 250°C)而不会丢失其预加载代码,这是众所周知的,许多新兴存储器尚未能够证明这一点。
PCRAM
PCRAM 器件使用硫属化物玻璃(最常用的化合物是 Ge2Sb2Te5,或 GST)的非晶态和晶态之间的电阻率差异来存储逻辑电平。该器件由顶部电极、硫族化物相变层和底部电极组成。泄漏路径被与相变元件串联的存取晶体管(或二极管)切断。
相变写入操作包括:(1) RESET,其中硫族化物玻璃通过短电脉冲瞬间熔化,然后快速淬火成具有高电阻率的非晶固体,以及 (2) SET,其中振幅较低但更长脉冲(通常 >100ns)将非晶相退火为低电阻晶态。1T-1R(或 1D-1R)单元比 NOR Flash 更大或更小,取决于使用的是 MOSFET 还是 BJT(或二极管。该设备可以被编程为任何最终状态而无需擦除先前状态,从而提供更快的编程吞吐量。简单的电阻器结构和低电压操作也使 PCRAM 对于嵌入式 NVM 应用具有吸引力。
PCRAM 的主要挑战是重置相变元件所需的高电流(fraction of mA),以及相对较长的设置时间和高温耐受性以在回流焊期间(约 250°C)保留预加载代码。热干扰是 PCRAM 可扩展性的潜在挑战。然而,热干扰效应是非累积的(不像闪存,其中导致电荷注入的编程和读取干扰是累积的)并且较高温度的RESET脉冲很短(10ns。相变材料与电极的相互作用可能会带来长期的可靠性问题并限制循环耐久性,是类 DRAM 应用的主要挑战。与 DRAM 一样,PCRAM 是真正的随机存取、位可变存储器。
已经使用碳纳米管作为电极证明, PCRAM 器件可以做到 < 5nm 的可扩展性,并且复位电流遵循较大器件的外推线。至少在一个案例中,证明了 1E11 的循环耐力。相变存储器从2011年开始用于功能手机,取代NOR Flash,2012年开始在~45nm节点量产,但此后没有新产品推出。在过去的几年中,PCM 存储器也被瞄准为嵌入式应用程序的 eFlash 替代品的潜在候选者 。在这些工作中,不同类别的相变材料的合金化允许获得符合焊接回流的存储器;然而,如此高的温度稳定性是以较慢的写入速度为代价的。
ReRAM:电阻式存储器
目前正在研究一大类两端器件,其中存储状态由金属-绝缘体-金属 (MIM:metal-insulator-metal ) 结构的电阻率决定,用于存储应用。其中许多电阻式存储器仍处于研究阶段。由于他们承诺缩小到 10nm 以下,并以极高的频率 (< ns) 和低功耗运行,过去十年中许多工业实验室的重点研发工作使这项技术被广泛认为是 NAND 的潜在继承者(包括 3D NAND ).
作为一种双端器件,高密度 ReRAM 的发展一直受到缺乏良好选择器器件的限制。然而,3D XP 内存的最新进展似乎已经解决了这个瓶颈,如果解决了不稳定位等其他技术问题,ReRAM 可能会取得快速进展。除了 3D XP 阵列(类似于基于 PCRAM 的 3D XP 存储器)之外,还可以使用 2D 阵列和小字线 (WL) 和小位线 (BL) 半间距制造高密度 ReRAM 产品。
此外,如果最终采用 OTS 类型的选择器器件,那么使用底部的晶体管和 3D 阵列中每个 ReRAM 器件的 OTS 选择器来制造 BiCS 型 3D ReRAM 似乎是可行的,如图 MM-10 所示。尽管由于引入 3D XP 内存似乎解决了双极选择器设备的瓶颈,但尚未推出高密度 ReRAM 产品,但可以合理预期 ReRAM 的进展。
然而最近,开发高密度 ReRAM 的热情似乎消退了。这可能是由于两个原因。(1) 3D NAND Flash的成功增加了进入门槛, (2) 难以满足大型阵列的可靠性要求。(请注意,针对嵌入式应用程序的较小 Mb 大小阵列成功开发 ReRAM 已发布多项公告。)
在过去的几年中,上述这些问题似乎注定了高密度 ReRAM 的大规模应用。最初关于 ReRAM 由数千个原子组成,不受统计波动影响的论点现在看来值得怀疑。似乎操作 ReRAM 的灯丝仅由几个原子(离子)组成。似乎有证据表明,即使是相对较大的 ReRAM 设备也会受到统计波动的影响。因此,我们不看好高密度应用的 ReRAM。
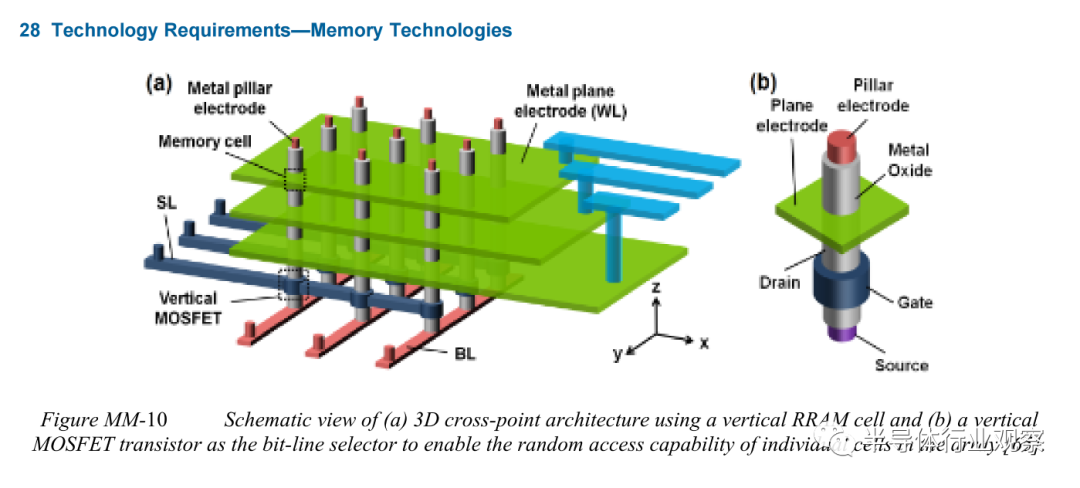
【本文由投资界合作伙伴微信公众号:半导体行业观察授权发布,本平台仅提供信息存储服务。】如有任何疑问,请联系(editor@zero2ipo.com.cn)投资界处理。






